투과전자현미경 측정문의:
☎ 031-299-6734, 송지호 책임연구원(TEM3) / 6735, 김현정 연구원(TEM2) / 6738, 김지혜 연구원(TEM1)
1. 투과전자현미경(Transmission Electron Microscopy) 측정원리
투과전자현미경(TEM)은 시료에 전자빔(electron beam)을 통과시켜 영상을 만드는 전자현미경이다. 영상을 만드는데 사용하는 빛의 파장이 짧을수록 분해능이 좋은데, 전자 현미경의 분해능은 가시광선을 사용하는 광학 현미경보다 수천 배 좋다. 시료 중을 전자가 통과하기 때문에 시료를 얇게 하거나, 시료 표면의 관찰에는 박막이나 레프리커를 이용한다. 전자렌즈의 구성을 변경하여 시료를 투과한 전자선의 회절상을 관찰할 수 있으며, 시료의 결정구조를 조사할 수 있다. 전자는 전하를 갖고 있어서 전자파나 X-선에 비하여 물질과 아주 민감하게 반응하여 강하게 회절되므로 국부적인 원자배열의 이미지 관찰 및 결정학 분석에 적합하며, 전자빔은 전자기 렌즈 등으로 수 Å 이내로 손쉽게 집속 시킬 수 있어서 미소 영역의 구조를 직접 괄찰이 가능하다.
EDS(Energy Dispersive X-ray Spectroscopy)
미지의 시편에서 방출된 특성 X-ray를 실리콘 단결정의 p-i-n 반도체 소자를 이용하여 에너지의 형태로 검출하는 방법
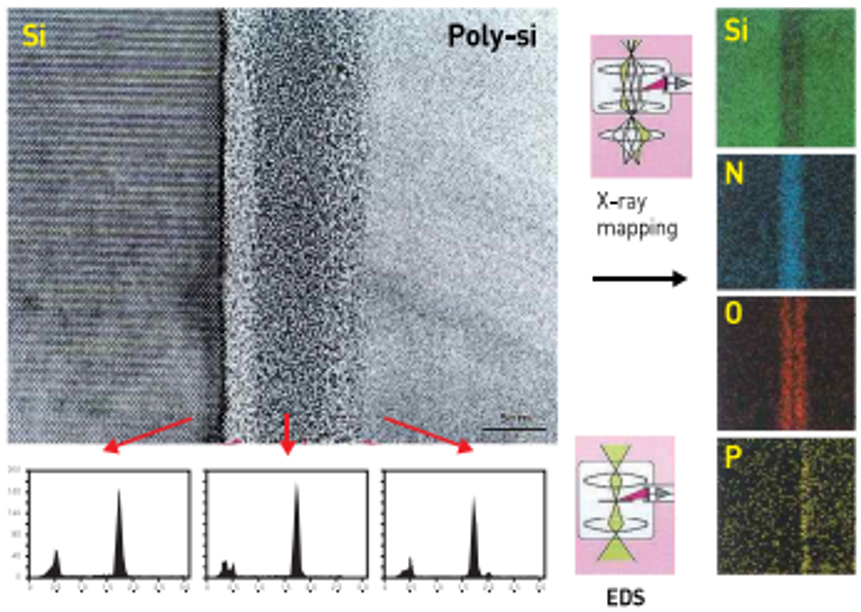
EELS(Electron Energy-Loss Spectroscopy)
재료와 전자빔의 충돌로 인해 손실된 전자 에너지를 스펙트럼으로 표현되는 분석법으로 투과전자현미경 기능은 그대로 유지하면서 추가적으로 재료내 화학적, 물리적, 전자적 정보를 획득할 수 있다. 영상콘트라스트 향상, 성분맵핑, 화학맵핑, 전자구조 분석을 통한 화학결합상태, Energy Loss near Edge structure(ELNES) 및 Extended Energy Loss Fine structure(EXELFS) 등 기초적이고 다양한 재료 정보를 얻을 수 있다.
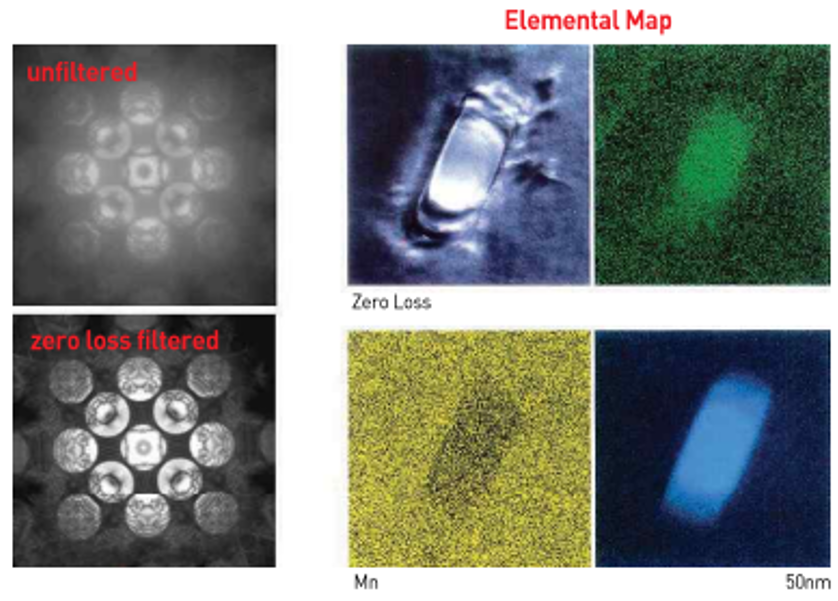
STEM(Scanning Transmission Electron Microscopy)
대물렌즈로 시편에 쪼여지는 전자빔을 더욱 집광시키고 좁은 영역으로 퍼지는 투과빔을 검출하여 영상화 시키는 방법으로 주사전자현미경과 투과전자현미경이 복합된 분석 방법이다. 명시야상(BF)과 암시야상(DF) 모드가 가능하며, EDS 및 EELS와 결합하여 미소영역의 분석에 유용하게 이용된다.
2. 활용 및 연구분야
| 연구분야 | 내 용 |
|---|---|
|
재료 과학 및 나노 과학 |
나노 물질의 크기, 모양, 구조 등을 연구하여 새로운 소재의 특성을 발견하거나 기존 소재를 개선하는 데 활용 |
|
생물학 및 의학 |
생체 조직, 세포 및 생체 분자를 높은 해상도로 관찰하여 세포 내 구조와 기능을 연구. 생물 응용 분야에서는 단백질, 바이러스, 세포 구조 등을 연구하는 데 활용 |
|
나노테크놀로지 |
나노입자의 형성, 구조 분석, 나노 레벨에서의 재료 특성 평가 등에 활용 |
|
재난 과학 |
화학적인 오염, 물질의 구조 변화, 소재의 파손 등을 분석 |
|
소자 및 반도체 연구 |
전자 기기나 반도체 소자의 미세 구조를 연구 |
|
물리학 및 화학 |
결정 구조, 결정체의 결함, 화학 반응 메커니즘 등을 연구하는 데 활용 |
3. 보유장비 스펙
*장비명을 선택하시면 상세스펙을 확인 할 수 있습니다.
| 장비명 | 단축명 | 모델명 | 영상분석 | EDS | STEM | EELS |
|---|---|---|---|---|---|---|
|
HRTEM 4 |
JEM-F200 |
○ |
○ |
○ |
X |
|
|
HRTEM 3 |
JEM-ARM200F |
○ |
○ |
○ |
○ |
|
|
HRTEM 2 |
JEM-2100F |
○ | ○ | ○ | X | |
|
HRTEM1 |
JEM-3010 |
○ | ○ | X | X |
4. 시험결과 예시자료
TEM Image (sample: Au particle)

결정구조분석(Select Area Diffraction)

STEM HAADF(3nm size의 core-shell structure particle에서 Mn의 조성차이 분석)
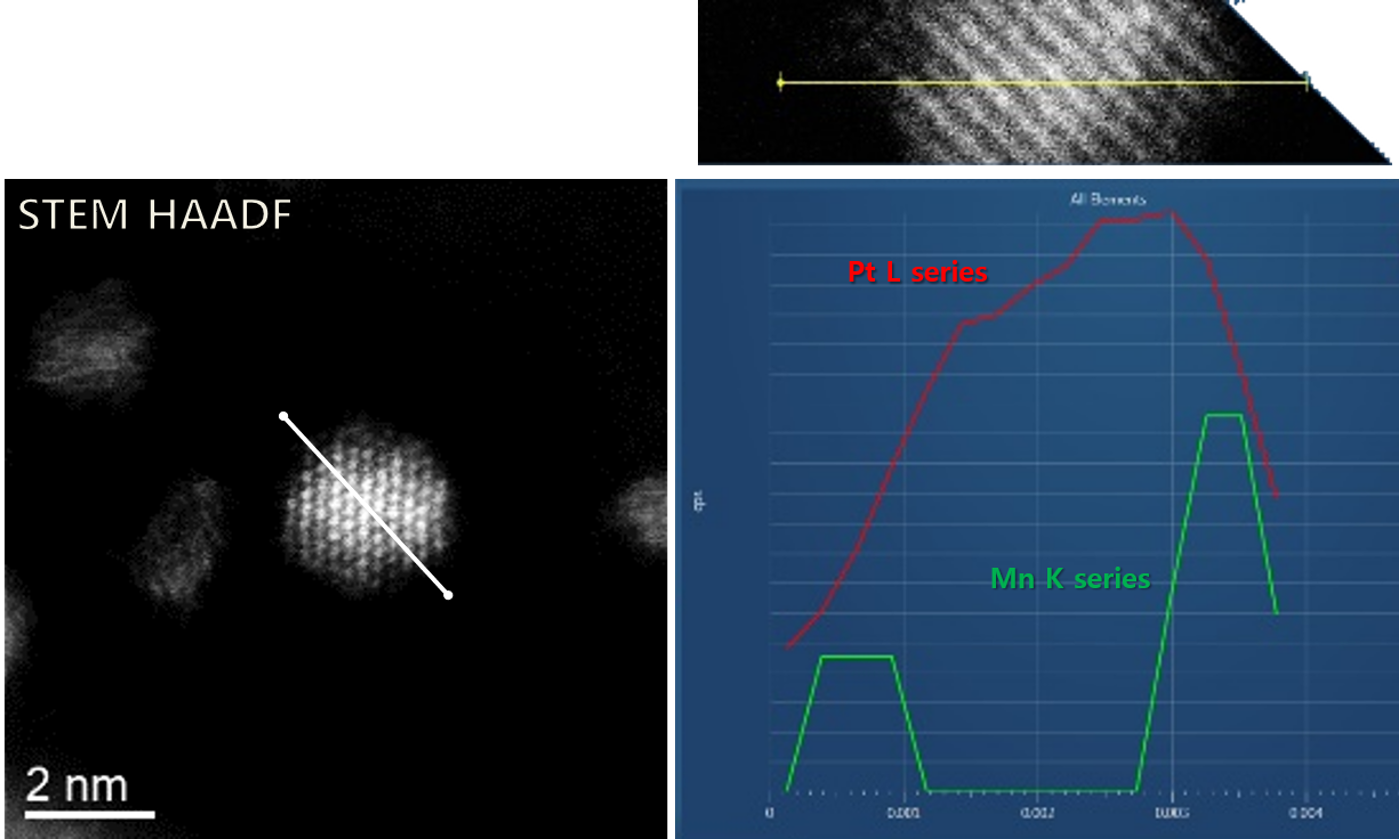
STEM image(Sample: Si <110>)

EDS분석(mapping, line scan, point)